Abstract
Spectroscopic ellipsometry (SE), photocarrier radiometry (PCR) and photoluminescence (PL) techniques were employed to measure the ultra-shallow junction (USJ) wafers. These USJ wafers were prepared by As+ ion implantation at energies of 0.5–5 keV, at a dose of 1×1015 As+/cm2 and spike annealing. Experimentally the damaged layer of the as-implanted wafer and the recrystallization and activation of the post-annealed wafer were evaluated by SE in the spectral range from 0.27 to 20 μm. The PCR amplitude decreased monotonically with the increasing implantation energy. The experimental results also showed that the PCR amplitudes of post-annealed USJ wafers were greatly enhanced, compared to the non-implanted and non-annealed substrate wafer. The PL measurements showed the enhanced PCR signals were attributed to the band-edge emissions of silicon. For explaining the PL enhancement, the electronic transport properties of USJ wafers were extracted via multi-wavelength PCR experiment and fitting. The fitted results showed the decreasing surface recombination velocity and the decreasing diffusion coefficient of the implanted layer contributed to the PCR signal enhancement with the decreasing implantation energy. SE, PCR and PL were proven to be non-destructive metrology tools for characterizing ultra-shallow junctions.
Similar content being viewed by others
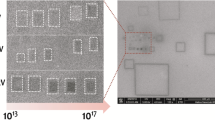
References
Shaughnessy D, Li B Ch, Mandelis A, et al. Ion implant dose dependence of photocarrier radiometry at multiple excitation wavelengths. Appl Phys Lett, 2004, 84: 5219–5221
Liu X M, Li B C H, Huang Q P. Thermal annealing induced photocarrier radiometry enhancement for ion implanted silicon wafers. Chin Phys B, 2010, 19: 97201–6
Xia J, Mandelis A. Radiative defect state identification in semi-insulating GaAs using photo-carrier radiometry. Semicond Sci Technol, 2009, 24: 125002
Xia J, Mandelis A. Direct search deep-level photo-thermal spectroscopy: an enhance reliability method for overlapped semiconductor defect-state characterization. Appl Phys Lett, 2010, 96: 262112
Melnikov A, Mandelis A, Tolev J, et al. Infrared lock-in carrierography (photocarrier radiometric imaging) of Si solar cells. J Appl Phys, 2010, 107: 114513
Liu X M, Li B Ch. IR variable angle spectroscopic ellipsometry study of high dose ion-implanted and annealed silicon wafers. J Appl Phys, 2009, 105: 013533-4
Lioudakis E, Christofides C, Othonos A. Study of the annealing kinetic effect and implantation energy on phosphorus-implanted silicon wafers using spectroscopic ellipsometry. J Appl Phys, 2006, 99: 123514–6
Shibata S, Kawase F, Kitada A, et al. Evaluation of pre-amorphous layer by spectroscopic ellipsometry. Int Conf Ion Implantation Technol Proc, 2008, 1066: 190–193
Radisic D, Shamiryan D, Mannaert G, et al. Metrology for implanted Si substrates loss studies. J Electrochem Soc, 2010, 157(5): H580–H584
Mandelis A, Batista J, Shaughnessy D. Infrared photocarrier radiometry of semiconductors: Physical principles, quantitative depth profilometry, and scanning imaging of deep subsurface electronic defects. Phys Rev B, 2003, 67: 205208
Palik E D. Handbook of Optical Constants of Solids. San Diego: Academic, 1998
Engstrom H. Infrared reflectivity and transmissivity of boron-implanted, laser-annealed silicon. J Appl Phys, 1980, 51: 5245–5249
Kasap S, Capper P. Handbook of Electronic and Photonic Materials. Heidelberg: Springer Science, 2006
Wang Ch H, Mandelis A, Tolev J, et al. H+ ion-implantation energy dependence of electronic transport properties in the MeV range in n-type silicon wafers using frequency-domain phtocarrier radiometry. J Appl Phys, 2007, 101: 123109
Li B Ch, Shaughnessy D, Mandelis A. Measurement accuracy analysis of photocarrier radiometric determination of electronic transport parameters of silicon wafers. J Appl Phys, 2005, 97: 023701
Schroder D K. Carrier lifetimes in silicon. IEEE Trans Electron Devices, 1997, 44: 160–170
Lauer K, Laades A, Übensee H, et al. Detailed analysis of the microwave-detected photoconductance decay in crystalline silicon. J Appl Phys, 2008, 104: 104503–9
Ng W L, Lourenco M A, Gwilliam R M, et al. An effective room-temperature silicon-based light-emitting diode. Nature, 2001, 410: 192–194
Stowe D J, Galloway S A, Senkader S, et al. Near-band gap luminescence at room temperature from dislocations in silicon. Physica B, 2003, 340–342: 710–713
Milosavljevic M, Shao G, Lourenco M A, et al. Engineering of boron-induced dislocation loops for efficient room-temperature silicon light-emitting diodes. J Appl Phys, 2005, 97: 073512
Author information
Authors and Affiliations
Corresponding author
Rights and permissions
About this article
Cite this article
Huang, Q., Li, B. & Ren, S. Optical and photo-carrier characterization of ultra-shallow junctions in silicon. Sci. China Phys. Mech. Astron. 56, 1294–1300 (2013). https://doi.org/10.1007/s11433-013-5091-8
Received:
Accepted:
Published:
Issue Date:
DOI: https://doi.org/10.1007/s11433-013-5091-8



